新聞中心
NEWS
清华大学和中国北京凝聚态物理国家实验室报道了独立式氮化镓衬底 (FGS) 在红铟镓氮化物 (InGaN) 微发光二极管 (LED) 中的应用,在器件阵列中的效率和均匀性 [Luming Yu et al, Appl. Phys. Lett., v123, p232106, 2023]。研究人员声称,以前没有报道过具有蚀刻定义台面尺寸为<5μm的InGaN红色micro-LED。
虽然在可见光谱的红色部分使用氮化铟镓(InGaN)很难实现高效率,但近年来已经付出了很多努力,特别是对于用于增强现实和虚拟现实(AR/VR)应用的微型显示器阵列中的微米级器件,例如军用飞机飞行员头盔中的抬头显示器(HUD)。
与更传统的红色 LED 材料(如铝铟镓磷化物 (AlInGaP))相比,InGaN 的优势包括更容易与绿色和蓝色 InGaN LED 集成,并且由于载流子向侧壁缺陷的迁移较少,因此可以更好地扩展到更小的器件尺寸,其中复合往往是非辐射的。
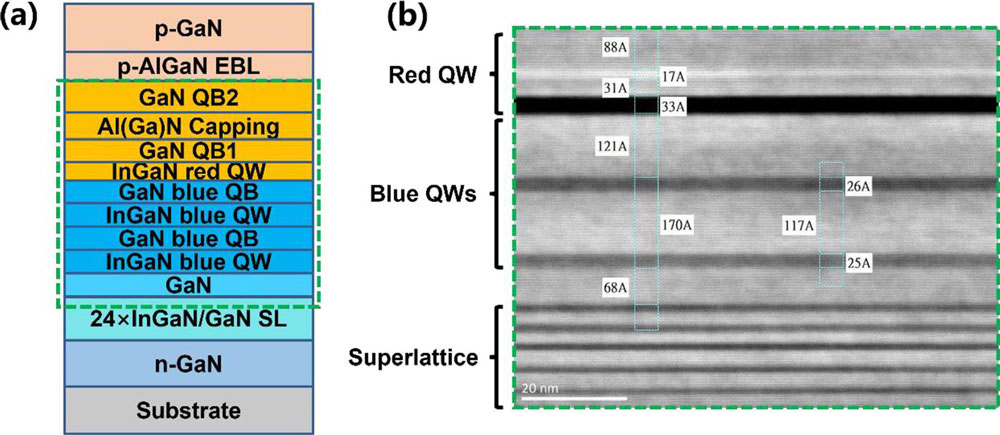
图1:(a)外延结构示意图。(b)(a)中绿框的放大透射电子显微镜(TEM)图像。
该结构包括由一个 24 周期的 InGaN/GaN 超晶格 (SL) 和两个蓝色 InGaN 量子阱 (QW) 组成的预应变层,由 GaN 量子势垒 (QB) 隔开。该结构的发光部分由单个QW和两个GaN阻挡层和氮化铝镓(AlGaN)封端层的三级结构组成。空穴注入由p掺杂的AlGaN电子阻挡层(EBL)和GaN接触层提供。
采用直写电子束光刻图案化、电感耦合等离子体刻蚀和等离子体增强化学气相沉积(PECVD)等离子体增强化学气相沉积(PECVD)技术制备了单个器件和红色InGaN LED阵列。这些设备不是有意优化的。
电气测试使用接触式探针在晶圆上进行。光通过基板以 60° 半角锥体收集。
反向电流泄漏测量表明,器件的侧壁严重损坏,这在较小器件尺寸下的性能占主导地位。−5V时的反向泄漏从10−3增加到1A/cm2,因为器件的尺寸从20μm减小到1μm。使用5A/cm2正向电流注入时,FGS(样品A)的峰值波长为631nm,PSS(样品B)的峰值波长为603nm。两种光谱都显示半峰全宽(FWHM)约为60nm。
研究人员评论说:“样品A的波长越长,归因于FGS的晶格常数较大,这有利于铟的掺入。
蓝色QW(~460nm)的发射强度大约低10倍以上。一些波长更短的~400nm辐射归因于电子在重新组合之前克服EBL并到达p-GaN接触层。
样品A在50A/cm2时达到的峰值外部量子效率(EQE)为1μm器件的73.20%,0μm器件的峰值外量子效率(EQE)为86.1%。峰值波长为614nm。在同一进样过程中,样品B的峰值EQE为1.05–1.62%,但波长已蓝移至590nm。一般来说,基于样品B(PSS)的LED的峰值波长比基于样品A(FGS)的LED短约40nm。
在光线追踪模拟的基础上,研究人员估计1μm LED的总峰值EQE在样品A上为1.95%,在样品B上为2.78%。相应的内部量子效率(IQE)估计为7.09%和6.00%。
在 10x10 阵列格式中,样品 A 的 1μm LED 在 0A/cm27 进样时的相对亮度变化为 10.2,在 0A/cm13 时的相对亮度变化为 100.2(图 2)。样本B的值分别为0.79和0.29。
